科盛科技研究发展部高级工程师 孙嘉蓬
在覆晶封装制程中,常使用点胶毛细力底部充填封装以达成保护组件之目的。制程如图一,利用点胶机直接在芯片边缘将封装材料注入,并藉由毛细作用使液状封装材料持续流动涵盖整个芯片底层。一般而言在点胶过程中除了胶量的控制外,为配合毛细作用的发挥,通常会将承载基板的底盘加热,并藉此加热基板,使封胶在滴入芯片与基板之间时可迅速的降低黏度,快速流动并且完全的充填于上下的间隙中。
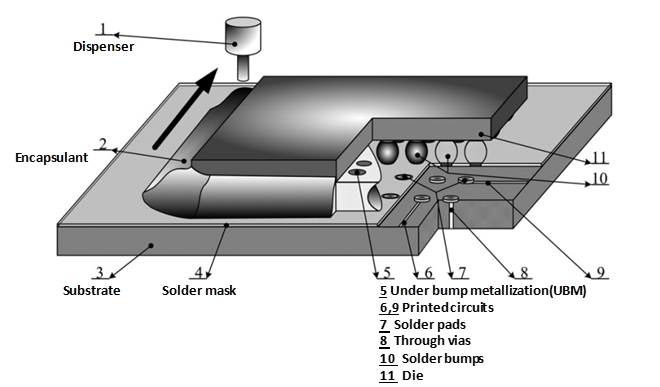
图一 点胶毛细力底部充填制程示意图 [1]
底部充填制程之驱动力为毛细力,所以对于气液相表面张力的描述与固液相墙壁吸附条件的导入会是重点仿真项目。气液相之间的毛细力主要以气液表面张力以及波前分布构成;充填材料与接触面(载板)的吸附力则可由平衡态的接触角描述。如图二,由Young’s equation可知此角度实际上为气液固三个不同相之间的表面张力或吸附力达成平衡后的结果,所以输入此接触角等同于控制三相之间的平衡状态。
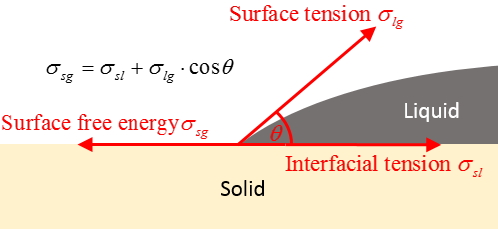
图二 Young’s equation
由于底部充填剂为热固性材料,执行底部充填封装之后的芯片,就很难再进行修理或重工。此外,只靠毛细力驱动的流动及烘烤使材料固化所需的时间,使得开发阶段进行实验试误法的成本提高。为了降低开发成本,采用CAE模拟分析找到最佳符合需求的设计控制是最有效的方案。
底部充填材料价格不斐,因此胶量控制也是制程中被重视的环节之一。除了点胶区域之外,爬胶行为使得胶体在芯片侧面的凸块区域在也有流入的现象,故掌握溢胶流动除了控制胶量的目的之外,也有助于分析波前造成的包封。如图三,在点胶给料之后,胶体的流动平衡主要受到三个驱动力而流动:毛细力、重力以及流体自身的黏滞力。因此胶量将包含毛细力充填流动、芯片侧向的爬胶边缘流动以及胶体自身塌陷在载板上向外延伸的流动行为。可想而知,要能完整的在透过CAE模拟了解胶体的使用,必须完整的针对这三种流动进行模拟。
图四中的模拟与实验结果,说明了重视点胶与爬胶流动区域对仿真的不可忽视性。传统的仿真方式忽略了点胶区域以及溢胶爬胶的效应,使得波前模拟缺少了爬胶由边缘给料的效果。为重视仿真结果之质量,Moldex3D 2020的毛细力底部充填模块中提供了完整的CAE分析。其中使用覆晶产品细节的三维模型(包含凸块分布与晶粒如图五)。点胶信息可设定包括多道路径、每道点胶量、点胶头移动起始时间及速度(图六)。材料参数可进行充填材料与不同材质接触面的接触角设定如图七,可模拟高分子行为受环境因子的变化。
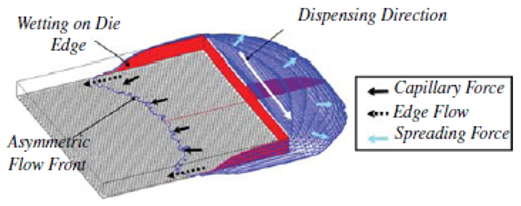
图三 胶体流动关系图 [2]

实验 [3]

传统模拟结果 [3]

Moldex3D 2020模拟结果
图四 实验与模拟中的爬胶行为
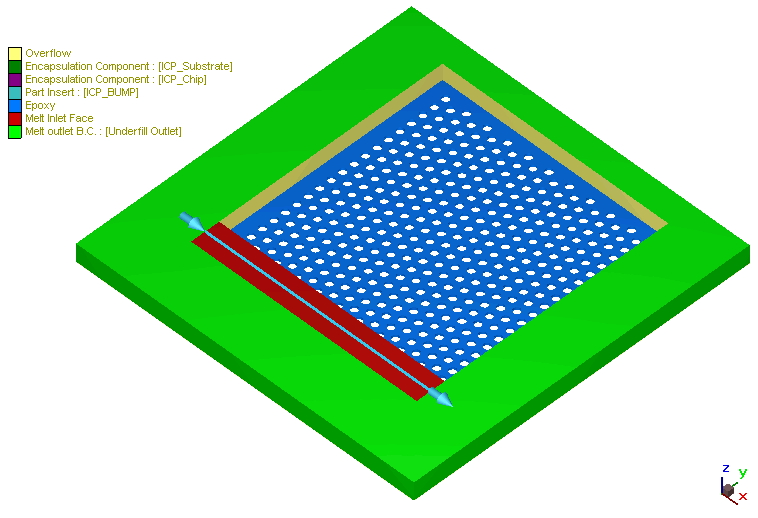
图五 3D模型

图六 点胶设定

图七 毛细力相关设定
Moldex3D可模拟的范围,包括流动时的「点胶过程」、「凸块区域的底部充填」以及「晶粒外部的流动 (爬胶与延伸流动)」如图八。图九显示点胶区域的胶体随着底部充填的过程而塌陷的状态变化,也代表了在科学模拟过程中,考虑完整的物理行为的必要性。

图八 充填分析
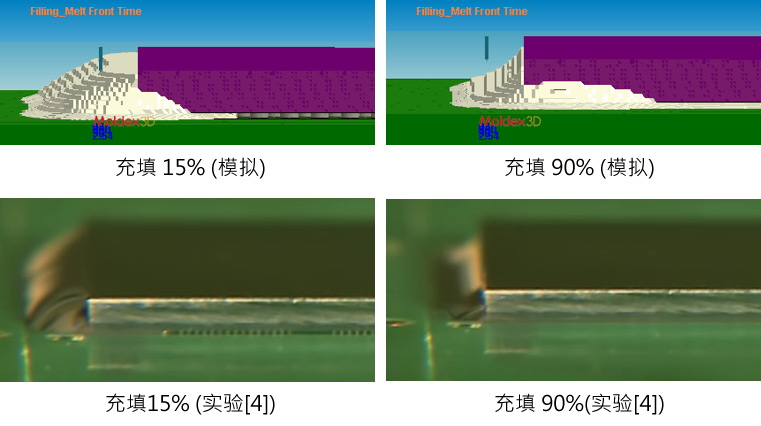
图九 点胶区域变化示意图
由此可见,面对行为复杂而试误成本高昂的底部充填封装制程,应用Moldex3D 2020可在设计时间就透过分析了解点胶控制与爬胶行为对底部充填的流动影响,以及使用胶体的总量控制以达成设计目的。
Reference
- Hui Wang, Huamin Zhou, Yun Zhang, Dequn Li and Kai Xu Three-dimensional simulation of underfill process in flip-chip encapsulation, Computers & Fluids 44 (2011) 187–201
- S.W.M. etc., 3-D Numerical Simulation and Validation of Underfill Flow of Flip-Chips. IEEE Transactions On Components, Packaging and Manufacturing Technology, Vol. 1, No. 10, October, (2011), pp. 1517-1522
- Sung-Won Moon, Zhihua Li, Shripad Gokhale, and Jinlin Wang, IEEE TRANSACTIONS ON COMPONENTS, 3-D Numerical Simulation and Validation of Underfill Flow of Flip-Chips (2011)
- Nordson ASYMTEK: The NexJet System – Flip Chip Underfill: https://www.youtube.com/watch?v=hdxjWJ2c0ao