当热固型塑料被加热,高分子便开始聚合。随着交联剂的加入,反应单元的官能基周围形成化学交联点和交联结构网络,交联反应会巩固高分子的分子链,形成坚固的三维结构聚合物。
后熟化制程就是将产品或模具暴露于升温的环境中,使其加速熟化过程,促进交联反应并适当地排列聚合物分子链,类似金属的加热,可增进材料的物理性质,如拉伸强度、弯曲强度及热变形温度等。
在新版Moldex3D R14.0中,后熟化模块除了支持一般熟化制程之外,也可应用于模内熟化(IMC)阶段,帮助使用者更容易研究材料的熟化情形并确保产品物理强度。以下将说明操作步骤:
进行分析前,材料必须输入的参数包括热固性塑料受压力、温度、交联反应所造成的体积变化(PVTC) 和黏弹参数。环氧树脂的熟化收缩为芯片封装的显著影响因子之一;而产品的热收缩及熟化收缩行为由P-V-T-C方程式支配,黏弹参数亦为后熟化(PMC)及模内熟化(IMC)制程中的必须参数。
Step 1 开启计算参数设定,切换至应力页签并在分析方式中选取后熟化。

Step 2 选择应力边界条件设定并点选编辑,以开启Moldex3D Designer,接下来可编辑边界条件。

点选新增位移并设定边界条件,再点选 ![]() 完成设定。
完成设定。

(提示:依照以下步骤设定基准点,则模拟分析的位移量值将以此基准点为准。选择三个正交点,增加三个方向固定于第一个点,增加X及Z方向固定于第二个点,增加Z方向固定于最后一点。)
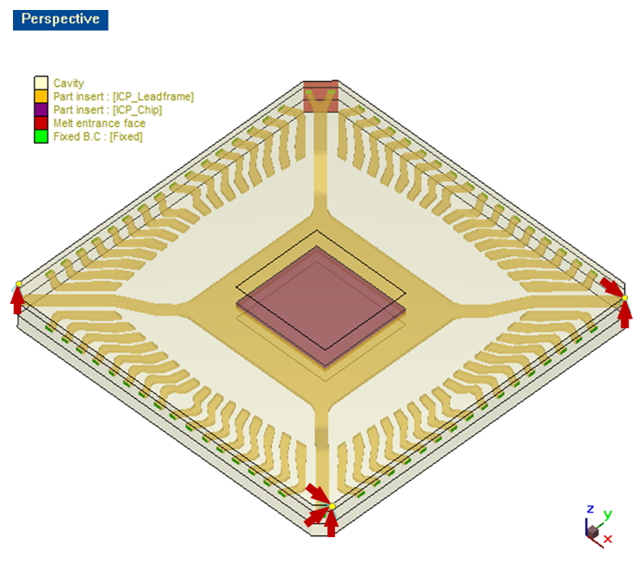
Step 3 点选后熟化计算设定并自行输入初始温度、时间增量、后熟化时间、热传系数。时间增量为分析迭代周期次数。

Step 4 开启环境温度vs.时间设定页并根据后熟化制程进行编辑。


Step 5 点选多段输出设定,使用者可自行决定输出的时间步数,也可选择在特定时间点输出分析结果。

Step 6 勾选考虑黏弹性材料特性的应力分析,并输入时间温度迭加参数,以下为Moldex3D支持之WLF方程式。
(提示:使用者也可选择预设WLF方程式作为黏弹计算参数。)

Step 7 开启广义Maxwell模型设置 。

根据材料性质,输入材料参数并确认窗口中的图型。

Step 8 开启熟化转换因子

根据材料特性,输入材料参数并确认窗口中的图型。

Step 9 双点击分析顺序设定 ![]() 并执行应力分析。
并执行应力分析。

(提示:在模内熟化分析时,使用者应先执行充填分析,再执行应力分析,模内熟化分析即可接续充填结束状态。此外,使用者执行后熟化分析前,需先执行充填分析及熟化分析。)