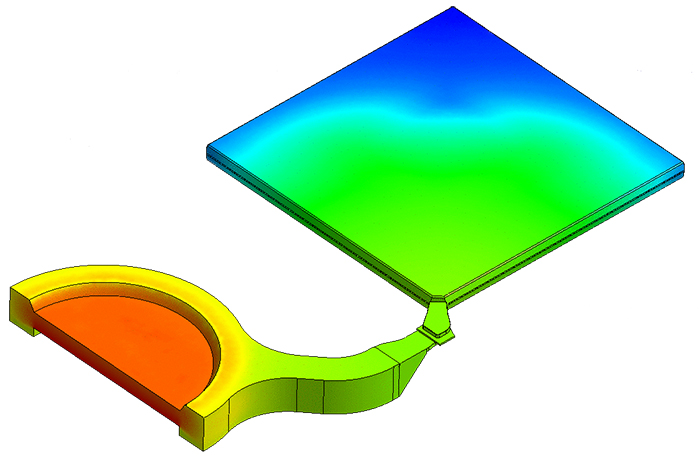
企业组 特别奖

作品名称: 运用 Moldex3D 解决包封问题并将封装流程优化
公司: STMicroelectronics
团队成员: Marco Rovitto
 作品大纲
作品大纲
STMicroelectronics 工程师运用 Moldex3D IC Packaging 解决方案将树酯充填不完整的风险降到最低。首先,此软件能重现因流动行为不平衡而引发的包封形成情况。之后,运用 Moldex3D 模拟将封装设计优化,降低发生问题的风险。最后,藉由更改几何形状发现对充填前推进有惊人效果,能在成型过程中避免产生结构瑕疵。Moldex3D 可用来成功在虚拟环境中预测问题,并可将模拟结果转化并整合至新成品的封装原型制造中。
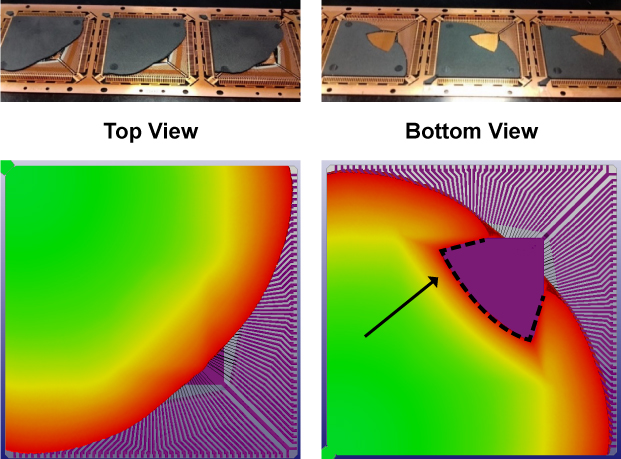
 挑战
挑战
- 改进不平衡的流动行为
- 减少结合线及包封
 解决方案
解决方案
根据 STMicroelectronics 设计师估计,藉由缩小标准配置的焊垫尺寸,就能减轻树酯在模穴顶部与底部之间流动不平衡的情形。由于已确定导线架焊垫属于关键位置,因此将其设计优化可对充填行为有极大帮助。事实上,此方法能减少成品的关键结合线数量。因此,此解决方案藉由先从设计着手解决包封的问题,而非从耗时昂贵的实验进行原型制造开始。
 效益
效益
- 找出关键结合线出现机率较高的位置
- 降低结合线会合角及形成包封的可能性
 使用产品(模块)
使用产品(模块)
 得奖团队
得奖团队


我十分荣幸能获颁 2020 Moldex3D 全球模流达人赛的特别奖!这代表我多年来在 Moldex3D 上耗费的心血是值得的。