- 日期:2012年 11月 2日 - 2012年 11月 15日
- 活动地点: 苏州

现今电子产品之趋势不但讲求轻薄短小、高可靠度、降低成本,同时于单一产品上之附加功能也愈来愈多,因此构装要求也日趋严苛。无论在材料、结构设计、制程、开发周期、良率都面临更严格之标准,使得制程面临许多挑战与遭遇各种缺陷,比如:包封、短射、金线偏移(wire sweep)、导线架偏移(paddle shift)等问题。另外,随着封装体尺寸缩小及结构复杂度增加,尤其是朝3D封装技术挑战下,除前述问题外,底部封胶(underfill)流场之变异更是近年来世界先进国家争先努力重点。但时至今日,相关问题机理与各项问题之解决方案仍未完善。以因应现今电子封装产业所面临的挑战,科盛科技将于11月2日到6日在苏州举办IC封装技术座谈会和IC封装模流分析体验营。我们特别邀请到两岸在IC封装产、学界知名专业人士来分享IC封装研究学术和如何利用模流分析来提高良率之实战经验和技术分享。
科盛科技诚挚地邀请您来参与我们这次的IC封装的技术研讨会,期待您的莅临与指教!
11/2 (五) 议程表: IC封装技术座谈会
| 时间 | 内容 | 主讲人 |
| 13:00 | 13:30 |
签到 | |
| 13:30 | 15:00 |
先进IC封装设计与制程优化技术
|
科盛科技公司 (CoreTech System) 刘育志 (Goran Liu) 讲师 |
| 15:00 | 15:10 |
休息 | |
| 15:10 | 16:00 |
仿真驱动半导体产品设计 | 达梭系统(上海)信息技术有限公司 (SIMULIA) 高绍武博士 (Dr. Gao Shao Wu) |
| 16:00 | 16:40 |
封装材料的特性与量测技术 | 台湾区电脑辅助成型技术交流协会 (ACMT) 刘文斌 (Webin Liu) 讲师 |
11/3 (六) IC封装模流分析体验营(一)
11/5 (一) IC封装模流分析体验营(二)
- 体验营讲师: 刘育志 (Goran Liu) 讲师
- 实际案例操作Moldex3D 模流分析软件,体验Moldex3D强大模拟计算功能。
- 分析模拟结果,预测制程可能出现问题,并提早改善产品缺陷。
精選案例
第一个案例为考量晶片及锡球之设计影响,将利用Flip Chip封装产品,探讨封胶之流动平衡性如何造成包封问题。第二个案例则是TSOP产品之导线架变形问题,探讨转注成型过程中因压力不平衡造成内部元件位移现象。藉由案例说明,学员可了解IC封装产品实际生产中可能遇到之问题,与如何运用CAE软体辅助,分析问题之关键因素及变更产品设计或成型参数,以达到优化产品封装品质之目的。

成功案例
UTAC成功应用Moldex3D封装模流分析技术,荣获第44届IMAPS国际论文奖
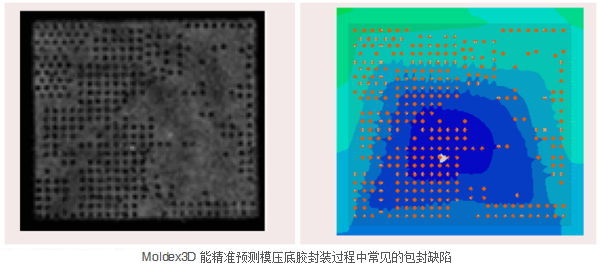

活动资讯
- 地点:215031 江苏苏州市平江区人民路3188 号C 座1609 室(万达广场)
- 日期:2012/11/2 (座谈会)
2012/11/3及11/5 (体验营) - 时间:13:00pm ~ 17:00 pm
- 课程费用:RMB 600, 每家公司可以享有一位免费名额
- 报名咨询:苏州模流分析软件有限公司 张林林 0512-62887663或18994377622